IGBIGBT的結構
圖1所示為一個N溝道增強型絕緣柵雙極晶體管結構,N+區稱為源區,附于其上的電極稱為源極。N+區稱為漏區。器件的控制區為柵區,附于其上的電極稱為柵極。溝道在緊靠柵區邊界形成。在漏、源之間的P型區(包括P+和P-區,溝道在該區域形成),稱為亞溝道區(Subchannel region)。
而在漏區另一側的P+區稱為漏注入區(Drain injector),它是IGBT特有的功能區,與漏區和亞溝道區一起形成PNP雙極晶體管,起發射極的作用, 向漏極注入空穴,進行導電調制,以降低器件的通態電壓。附于漏注入區上的電極稱為漏極。 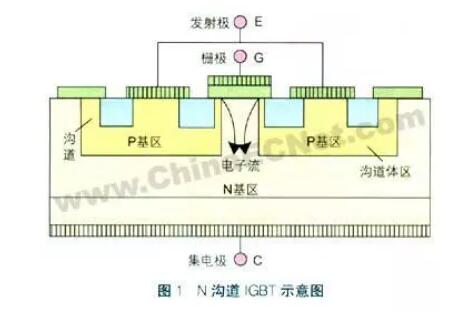
IGBT的開關作用是通過加正向柵極電壓形成溝道,給PNP晶體管提供基極電流,使
IGBT導通。反之,加反向門極電壓消除溝道,流過反向基極電流,使
IGBT關斷。
IGBT的驅動方法和MOSFET基本相同,只需控制輸入極N一溝道MOSFET,所以具有高輸入阻抗特性。當MOSFET的溝道形成后,從P+基極注入到N一層的空穴(少子),對N一層進行電導調制,減小N一層的電阻,使IGBT在高電壓時,也具有低的通態電壓。
IGBT的工作特性
1.靜態特性
IGBT的靜態特性主要有伏安特性、轉移特性和開關特性。
此時,通態電壓 Uds(on)可用下式表示:
Uds(on) = Uj1 + Udr + IdRoh
式中 Uj1 —— JI結的正向電壓,其值為 0.7 ~1V ; Udr —— 擴展電阻Rdr上的壓降; Roh —— 溝道電阻。
通態電流Ids可用下式表示:
Ids=(1+Bpnp)Imos
式中 Imos —— 流過MOSFET的電流。
由于N+區存在電導調制效應,所以
IGBT的通態壓降小,耐壓1000V的
IGBT通態壓降為2~3V 。
IGBT處于斷態時,只有很小的泄漏電流存在。
2.動態特性
IGBT在開通過程中,大部分時間是作為MOSFET來運行的,只是在漏源電壓Uds下降過程后期,PNP晶體管由放大區至飽和,又增加了一段延遲時間。td(on)為開通延遲時間,tri為電流上升時間。實際應用中常給出的漏極電流開通時間ton即為td(on)、tri之和。漏源電壓的下降時間由tfe1和tfe2組成。
IGBT的觸發和關斷要求給其柵極和基極之間加上正向電壓和負向電壓,柵極電壓可由不同的驅動電路產生。當選擇這些驅動電路時,必須基于以下的參數來進行:器件關斷偏置的要求、柵極電荷的要求、耐固性要求和電源的情況。 因為
IGBT柵極—發射極阻抗大,故可使用MOSFET驅動技術進行觸發,不過由于
IGBT的輸入電容較MOSFET為大,故
IGBT的關斷偏壓應該比許多MOSFET驅動電路提供的偏壓更高。
IGBT的開關速度低于MOSFET,但明顯高于GTR。IGBT在關斷時不需要負柵壓來減少關斷時間,但關斷時間隨柵極和發射極并聯電阻的增加而增加。IGBT的開啟電壓約3~4V,和MOSFET相當。IGBT導通時的飽和壓降比MOSFET低而和GTR接近,飽和壓降隨柵極電壓的增加而降低。 正式商用的高壓大電流
IGBT器件至今尚未出現,其電壓和電流容量還很有限,遠遠不能滿足電力電子應用技術發展的需求,特別是在高壓領域的許多應用中,要求器件的電壓等級達到10KV以上。目前只能通過
IGBT高壓串聯等技術來實現高壓應用。
國外的一些廠家如瑞士ABB公司采用軟穿通原則研制出了8KV的
IGBT器件,德國的EUPEC生產的6500V/600A高壓大功率
IGBT器件已經獲得實際應用,日本東芝也已涉足該領域。與此同時,各大半導體生產廠商不斷開發
IGBT的高耐壓、大電流、高速、低飽和壓降、高可靠性、低成本技術, 主要采用1um以下制作工藝,研制開發取得一些新進展。
IGBT的工作原理
N溝型的IGBT工作是通過柵極 — 發射極間加閥值電壓VTH以上的(正)電壓,在柵極電極正下方的p層上形成反型層(溝道),開始從發射極電極下的n-層注入電子。該電子為p+n-p晶體管的少數載流子,從集電極襯底p+層開始流入空穴,進行電導率調制(雙極工作),所以可以降低集電極 — 發射極間飽和電壓。 在發射極電極側形成n+pn — 寄生晶體管。若n+pn — 寄生晶體管工作,又變成 p+n — pn+晶閘管。電流繼續流動,直到輸出側停止供給電流。通過輸出信號已不能進行控制。一般將這種狀態稱為閉鎖狀態。 為了抑制n+pn — 寄生晶體管的工作
IGBT采用盡量縮小p+n-p晶體管的電流放大系數α作為解決閉鎖的措施。具體地來說,p+n-p的電流放大系數α設計為0.5以下。
IGBT的閉鎖電流IL為額定電流(直流)的3倍以上。
IGBT的驅動原理與電力MOSFET基本相同,通斷由柵射極電壓uGE決定。
1.導通
IGBT硅片的結構與功率MOSFET的結構十分相似,主要差異是
IGBT增加了P+基片和一個N+緩沖層(NPT-非穿通-
IGBT技術沒有增加這個部分),其中一個MOSFET驅動兩個雙極器件。基片的應用在管體的P+和N+區之間創建了一個J1結。當正柵偏壓使柵極下面反演P基區時,一個N溝道形成,同時出現一個電子流,并完全按照功率MOSFET的方式產生一股電流。
如果這個電子流產生的電壓在0.7V范圍內,那么,J1將處于正向偏壓,一些空穴注入N-區內,并調整陰陽極之間的電阻率,這種方式降低了功率導通的總損耗,并啟動了第二個電荷流。
最后的結果是,在半導體層次內臨時出現兩種不同的電流拓撲:一個電子流(MOSFET 電流)、空穴電流(雙極)。uGE大于開啟電壓 UGE(th)時,MOSFET內形成溝道,為晶體管提供基極電流,IGBT導通。
2.導通壓降
電導調制效應使電阻 RN 減小,使通態壓降小。
3.關斷
當在柵極施加一個負偏壓或柵壓低于門限值時,溝道被禁止,沒有空穴注入N-區內。在任何情況下,如果MOSFET電流在開關階段迅速下降,集電極電流則逐漸降低,這是因為換向開始后,在N層內還存在少數的載流子(少子)。 這種殘余電流值(尾流)的降低,完全取決于關斷時電荷的密度,而密度又與幾種因素有關,如摻雜質的數量和拓撲,層次厚度和溫度。少子的衰減使集電極電流具有特征尾流波形,集電極電流引起以下問題:功耗升高;交叉導通問題,特別是在使用續流二極管的設備上,問題更加明顯。
鑒于尾流與少子的重組有關,尾流的電流值應與芯片的溫度、IC和VCE密切相關的空穴移動性有密切的關系。因此,根據所達到的溫度,降低這種作用在終端設備設計上的電流的不理想效應是可行的,尾流特性與VCE、IC和TC有關。
柵射極間施加反壓或不加信號時,MOSFET內的溝道消失,晶體管的基極電流被切斷,
IGBT關斷。
4.反向阻斷
當集電極被施加一個反向電壓時,J1就會受到反向偏壓控制,耗盡層則會向N-區擴展。因過多地降低這個層面的厚度,將無法取得一個有效的阻斷能力,所以這個機制十分重要。 另一方面,如果過大地增加這個區域尺寸,就會連續地提高壓降。
5.正向阻斷
當柵極和發射極短接并在集電[敏感詞]子施加一個正電壓時,P/NJ3結受反向電壓控制。此時,仍然是由N漂移區中的耗盡層承受外部施加的電壓。
6.閂鎖
IGBT在集電極與發射極之間有一個寄生PNPN晶閘管,在特殊條件下,這種寄生器件會導通。這種現象會使集電極與發射極之間的電流量增加,對等效MOSFET的控制能力降低, 通常還會引起器件擊穿問題。
晶閘管導通現象被稱為IGBT閂鎖,具體地說,這種缺陷的原因互不相同,與器件的狀態有密切關系。通常情況下,靜態和動態閂鎖有如下主要區別:當晶閘管全部導通時,靜態閂鎖出現。只在關斷時才會出現動態閂鎖。這一特殊現象嚴重地限制了安全操作區。 為防止寄生NPN和PNP晶體管的有害現象,有必要采取以下措施:
-
一是防止NPN部分接通,分別改變布局和摻雜級別。
-
二是降低NPN和PNP晶體管的總電流增益。
此外,閂鎖電流對PNP和NPN器件的電流增益有一定的影響,因此,它與結溫的關系也非常密切;在結溫和增益提高的情況下,P基區的電阻率會升高,破壞了整體特性。因此,器件制造商必須注意將集電極[敏感詞]電流值與閂鎖電流之間保持一定的比例,通常比例為1:5。
免責聲明:本文轉載自“ittbank”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。
公司電話:+86-0755-83044319
傳真/FAX:+86-0755-83975897
郵箱:1615456225@qq.com
QQ:3518641314 李經理
QQ:202974035 陳經理
地址:深圳市龍華新區民治大道1079號展滔科技大廈C座809室