服務熱線
0755-83044319

發布時間:2022-03-18作者來源:薩科微瀏覽:3458
基金項目:深圳科創委項目(JCYJ20180508161601937)
1
功率電子器件正在向著高頻率、高密度、高功率和高溫應用的方向發展[1]。目前,硅(Si)基器件仍占據主導地位,然而由于材料本身的特性,硅基器件的開關頻率、工作溫度和功率密度等受到了限制。相對于傳統硅基器件,第三代半導體如碳化硅(SiC)和氮化鎵(GaN)等器件,由于具有更高的擊穿電壓、更寬的能帶隙、更高的熱導率和更低的功率損耗,越來越多地應用在如無線通訊、電動汽車、航空航天等高電壓、高溫度和高頻率的應用領域中[2-3]。但與此同時,第三代半導體器件的迅速發展,也對封裝技術提出了更為嚴苛的要求。
封裝技術是一種將芯片與承載基板連接固定、引出管腳并將其塑封成整體功率器件或模塊的工藝,主要起到電氣連接、結構支持和保護、提供散熱途徑等作用[4]。封裝作為模塊集成的核心環節,封裝材料、工藝和結構直接影響到功率模塊的熱、電和電磁干擾等特性。目前成熟的封裝技術主要是以銀膠或錫基釬料等連接材料、引線連接等封裝結構為主,耐高溫、耐高壓性能差,電磁兼容問題突出,無法提供高效的散熱途徑。近來,燒結銀互連材料、三維集成封裝結構等由于具有優異的耐高溫、高導熱性能,可以實現雙面散熱、大幅降低開關損耗,使得功率模塊具有良好的熱、電特性和可靠性,獲得了越來越多的研究和關注,有望滿足第三代半導體器件在高溫、高壓和高頻領域的可靠應用。本文針對功率電子封裝材料和結構設計的[敏感詞]研究進展進行了總結和展望。
2
典型的功率模塊封裝結構如圖1所示,由功率芯片、連接材料、鍵合引線、陶瓷基板、底板、灌封材料、外殼和功率端子等組成[3,5]。各封裝材料的熱、電、機械和化學性質不同,因此在封裝時需要綜合考慮各材料的性能進行選擇,使整個功率模塊達到最優的性能。
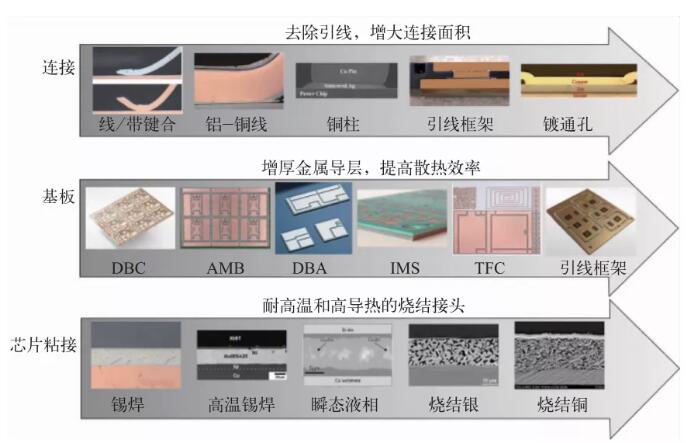
圖1 典型的功率模塊封裝結構[5]
芯片粘接、連接和基板等關鍵封裝材料與技術的發展趨勢如圖2所示。連接技術從鍵合引線向帶狀、銅柱、引線框架和電鍍通孔等方向發展,通過去除引線、增大連接面積來提高導熱和導電性能。芯片粘接材料從傳統錫焊向金基高溫釬焊、瞬態液相連接、燒結銀和燒結銅等方向發展,大幅提高導熱和導電性能,滿足高溫可靠應用。基板向著增厚陶瓷基板的金屬導電導熱層發展,從而提高散熱效率[5]。
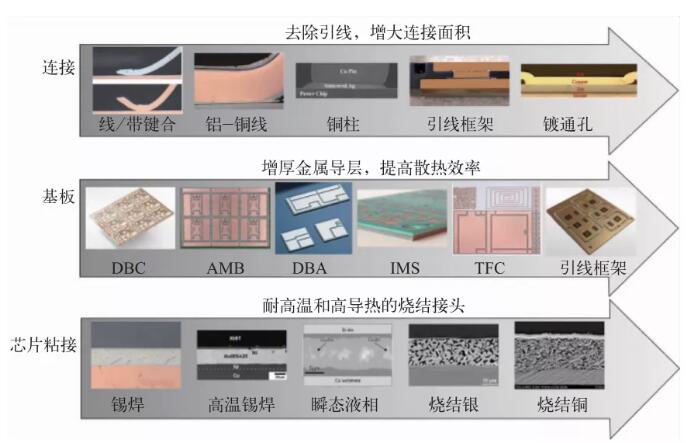
圖2 連接、基板和芯片粘接等封裝材料和技術的發展趨勢[5]
常用半導體材料的性能參數如表1所示[6-7]。Si因為技術成熟和成本低等特點,目前被廣泛應用在各類分立器件和集成電路、電子信息網絡工程等領域。相比于Si,GaAs具備禁帶寬度大、電子遷移率高的特性,能顯著減小射頻尺寸、降低功耗,在射頻、無線通信和光電子領域的中低功率器件方面得到廣泛應用。SiC和GaN具有更大的禁帶寬度,在高溫工作時不易吸收熱輻射能量跳變到導帶,并且具有更高的擊穿場強,所以寬禁帶半導體SiC和GaN比Si更適用于高溫和高壓場合。SiC的熱導率更大,散熱能力更好,具有較高的載流子遷移率,能夠提供較高的電流密度,并且耐高溫、耐高壓,因此常被用做功率器件,在電壓600 V及以上的高功率領域具有顯著優勢,在新能源汽車和電力設備等領域應用廣泛。GaN的電子遷移率和載流子速度更快,在高壓時的導通電阻和寄生參數更小,在高功率射頻方向具備明顯優勢。因為GaN具有高功率密度、低能耗、適合高頻率、支持更寬帶寬等特點,主要用于5G通信和衛星通訊等微波射頻領域、消費電子快充和新能源汽車等電力電子領域以及LED光電子等領域。與SiC類似,目前GaN技術仍在快速發展階段,成本相對較高。
表1 半導體芯片材料的性能[6]
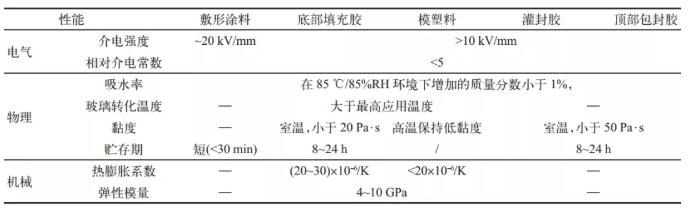
SnPb合金釬料如Sn63Pb37,由于其優異的性能,如較低的剪切模量,較高的潤濕性、延展性、熱-機械性能和可靠性,曾被廣泛應用于芯片粘接材料。但是SnPb不符合歐盟RoHS無鉛標準,并且熔點較低(180 ℃左右),因此需要新的芯片粘接材料來滿足封裝結構和材料的熱膨脹系數(CTE)匹配和耐高溫的應用需求。
目前應用最廣泛的芯片粘接材料如表2所示[8]。導電銀膠主要由樹脂基體、導電粒子(主要為銀粉)和分散添加劑、助劑等組成,其電導率和熱導率相對較低,玻璃化溫度約為100~150℃,在高溫、高壓芯片封裝領域受到限制。與SnPb釬料相比,無鉛釬料如SnAg或SnAgCu等,Sn含量一般高于90%,熔點相對較高(220 ℃左右),在凝固過程中過冷度較大,容易形成粗大的樹枝晶組織及金屬間化合物,并呈不均勻分布,使其抗蠕變性減弱。此外,SnAgCu合金有較高的彈性模量,CTE與芯片和基板相差較大,在熱循環載荷作用下易發生疲勞破壞導致焊點剝離,降低了焊點可靠性[9]。
表2 芯片粘接材料性能[8]
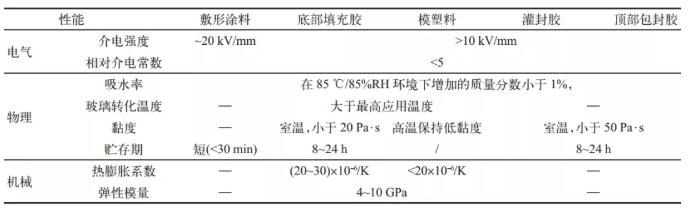
高溫芯片粘接材料,如AuSn或AuGe等金基共晶合金釬料,具有較高的熔點(大于280 ℃)、熱導率和電導率,并且容易實現無釬劑釬焊。然而,金基釬料中的金含量普遍較高,成本高昂,并且由于組成相具有高脆性,導致加工難度大、成品率低、產品性能差等缺點,嚴重影響其在功率電子封裝領域中的廣泛應用[10]。
瞬態液相連接(Transient Liquid Phase Bonding, TLPB)是在熔點較高的被連接母材(如Cu、Au、Ag、Ni)中間加入熔點較低的中間層(如In、Sn),加熱使中間層與部分母材熔化并重新凝固,固液之間互相擴散而形成連接的過程。選擇合適的材料和工藝,瞬態液相連接可以形成性能優異的接頭,如連接強度大于60 MPa[11]。但由于中間層的選擇較少、成本較高,以及Au-In等材料的氧化問題,瞬態液相連接在高溫芯片互連的應用中受到較大限制。
燒結銀互連也稱為低溫連接技術,是基于納米銀或微米銀顆粒的固相原子擴散形成燒結連接。燒結銀工藝溫度低(200~300℃),熔點高(961 ℃),具有如熱導率高、抗溫度循環和功率循環可靠性高等眾多優點,成為高溫芯片互連的優先選擇,得到了越來越廣泛的研究和應用[12]。但是燒結銀也有一些缺點,如成本較高,納米銀顆粒易低溫團聚,微米銀焊膏需要加壓燒結,工藝復雜,并且需要芯片和基板表面進行Ni/Au或Ni/Ag等金屬鍍層處理,以及存在銀容易發生電化學遷移等問題。相比于納米銀焊膏,納米銅焊膏由于成本較低,無電化學遷移的可靠性風險,最近開始引起關注[13]。但納米銅顆粒易氧化,需要在惰性氣氛中燒結,增加了工藝復雜度和設備成本,具有一定的應用局限性。
塑封材料的主要功能是電氣絕緣和環境隔離,起到防潮、防鹽霧、防霉、防塵、防碰撞和防振等防護作用,避免遭受環境的腐蝕與破壞,從而保證電子組件的電氣性能,甚至提高高壓功率模塊的電壓等級,避免電極放電,最終提高電子產品的可靠性[14]。塑封材料的種類和性能如表3所示,塑封材料可分為敷形涂料(Conformal Coatings)、底部填充膠(Underfills)、模塑料(Molding Compounds)、灌封膠(Potting Compounds)和頂部包封膠(Glob Tops)[14]。
表3 塑封材料的種類和性能[14]
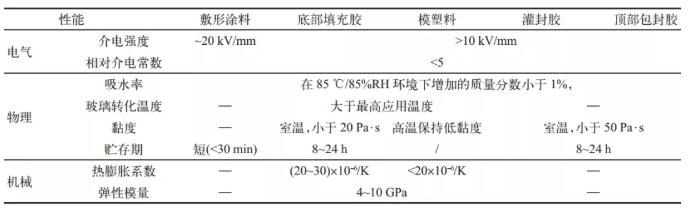
敷形涂料是一種常用于印制線路表面防護的有機涂料,需要與基板和組件有良好的連接性能。一般選擇具有低吸水率、高介電強度、匹配的CTE、低彈性模量的材料,如可在小于120 ℃低溫使用的丙烯酸,在小于165 ℃中低溫使用的聚氨酯,在小于200 ℃中溫使用的環氧樹脂,以及可在大于250 ℃高溫使用的硅樹脂、聚對二甲苯、苯并環丁烯和聚酰亞胺等。
底部填充膠和模塑料如圖3所示,其作用除了可以與周圍環境隔離和降低電場應力,還可以通過降低或重新分布由CTE不匹配帶來的熱-機械應力來提高封裝產品的可靠性[14]。因此,應該盡可能選擇與封裝結構內各組件CTE相匹配的材料,如CTE為(20~30)×10-6/K和小于20×10-6/K的硬質材料分別作為底部填充膠和模塑料來分別降低來自焊錫球以及包括焊錫球在內的整個封裝結構的熱應力。目前,最常用的底部填充膠和模塑料為二氧化硅填充的環氧樹脂。
灌封膠和頂部包封膠除了提高抗電場擊穿的電壓等級和避免周圍環境的腐蝕與破壞等,還對封裝結構起到一定的機械支撐作用。目前最常用的灌封膠和頂部包封膠材料為可在小于165 ℃低溫應用的聚氨酯,在小于200 ℃中溫應用的環氧樹脂,以及在小于300 ℃高溫應用的硅橡膠或凝膠等。其中硅橡膠或凝膠等軟質材料由于具有較低的硬度和模量、較高的塑性和彈性,對芯片、鍵合線等封裝組件的應力影響較小,得到了最廣泛的應用。但硅橡膠和凝膠等軟質材料的機械支撐和保護性能較差。為了抵抗外部沖擊,可以選擇樹脂等硬質材料。但是樹脂通常具有較高的模量,需要選擇CTE匹配的材料,避免對整個封裝結構帶來過大的熱-機械應力。

(b)模塑料示意圖
圖3 功率電子封裝結構中的底部填充膠和模塑料示意圖[14]
一般來說,基板是一個“金屬導電層-絕緣層-金屬導電層”的三明治結構,上下兩層金屬導電層分別用于芯片和底板的互連。根據制造工藝,基板可分為直接覆銅基板(Direct Bonded Copper,DBC)、直接電鍍基板(Direct Printed Copper,DPC)、直接覆鋁基板(Direct Bonded Aluminum,DBA)、活性金屬釬焊基板(Active Metal Brazing,AMB)、絕緣金屬基板(Insulated Metal Substrate,IMS)以及厚膜印刷基板(Thick-film Printed Copper,TPC)等。
DBC基板是在銅膜上采用薄氧化銅與陶瓷形成共晶連接,其兼具優異的性能和相對較低的成本,在功率電子封裝中得到了最廣泛的應用。然而,陶瓷連接界面處的氧化銅薄膜容易分層,造成DBC基板的抗溫度循環可靠性較低。AMB基板是采用活性金屬釬焊將金屬和陶瓷連接在一起,可以消除氧化層,提高可靠性。DBA基板是采用AlSi釬焊來連接鋁板和陶瓷,相對于DBC的銅層來說,鋁層的硬度更低,可以承受更高的熱-機械應力,提高可靠性[15]。但鋁的熱導率比銅低,DBA基板的散熱性能不如DBC基板。IMS基板包括一層高導熱的絕緣樹脂、一層銅底板和厚銅膜。與DBC相比,IMB制造工藝簡單、熱處理溫度低、成本低、可靠性高。TPC基板是在陶瓷上絲網印刷一層銅膏,通過在850~950 ℃高溫燒結,形成金屬膜與陶瓷的高強度連接,溫度循環可靠性較高,可與集成電路芯片和無源器件高度集成來形成混合模塊。最近也出現了基于厚引線框架-薄絕緣層的基板,簡化了多層基板結構,提高了散熱效率[5]。
綜合考慮熱導率和CTE等,Al2O3、Si3N4、AlN和BeO是基板中最常用的陶瓷材料,其性能比較見表4[8,16]。BeO具有[敏感詞]的熱導率,但是制備過程中的微塵對人體有害,導致其應用受到很大限制。Al2O3是最經濟的選擇,但是機械強度適中,導熱性能相對較差。AlN的熱導率比Al2O3更高,CTE與芯片更匹配。Si3N4具有更高的溫度循環可靠性,但成本相對較高[17]。相對而言,Al-AlN和Cu-Si3N4的組合可靠性更高,其原因是前者鋁材料較軟,彈性模量較低,容易變形,可以減緩熱應力對陶瓷造成的損傷;后者Si3N4的抗彎強度和斷裂韌性較大,可以抵抗銅帶來的熱應力。
表4 基板中的陶瓷材料性能[8]

最常用的底板材料為Cu,為了降低CTE和保證高熱導率,金屬復合材料如AlSiC、W-Cu、Mo-Cu、以及Cu-Mo-Cu也得到廣泛應用,其性能參數見表5[8]。底板一般會做鍍鎳處理,可以防止高溫下銅原子的遷移和氧化,提高銅底板的強度和變形抗力。
表5 底板材料性能[8]
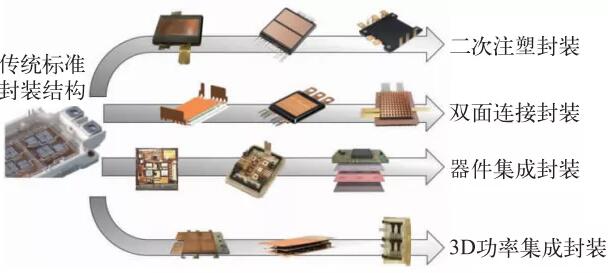
3
根據芯片組裝方式和互連工藝的不同,功率電子封裝結構可分為焊接式封裝和壓接式封裝兩種形式。封裝結構的發展趨勢如圖4所示,其中焊接式封裝可以采用引線鍵合、倒裝芯片(BGA互連)、金屬柱互連、凹陷陣列互連、沉積金屬膜互連等結構。壓接式封裝是借助外界機械壓力形成互連結構。為了便于對比分析,將上述幾種封裝方式的優缺點列于表6[18]。引線鍵合具有技術成熟、成本低、布線靈活等優點。然而,引線鍵合的模塊具有較高的寄生電感,只能從底板單面散熱[18]。并且,由于鍵合引線和芯片的CTE不匹配,產生較大的熱-機械應力,使得焊點易疲勞失效,成為模塊在功率循環過程中最主要的失效形式。
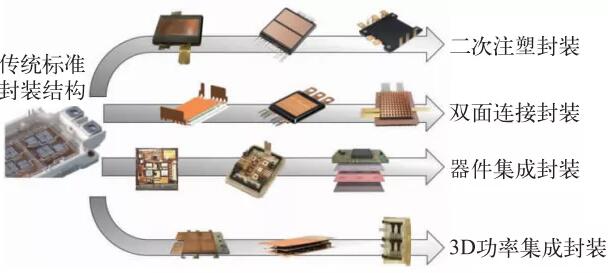
圖4 封裝結構的發展趨勢[5]
表6 封裝結構對比[18]

目前功率電子封裝結構逐漸從傳統的引線鍵合標準封裝結構向二次注塑(Overmold)、雙面連接(Double-Side Bonding)、器件集成(Component Integration)、三維功率集成封裝結構(3D Power Integration)發展。通過去除引線,可以降低電磁干擾、提高散熱效率、增大集成度。其中,注塑結構為緊湊型平面封裝,易于批量模塊生產;雙面連接結構可以實現雙面散熱,提高散熱效率;器件集成結構可以將多種功能集成在模塊內部,提高開關速度;三維功率集成結構是將芯片在垂直方向上堆疊連接,可大幅降低寄生電感,提升開關性能[5]。相比于二維封裝,三維封裝具有顯著的優點,如可以在垂直方向上大大縮短回路距離,降低寄生電感和電磁干擾,提高傳輸速度,提高開關性能,降低功率損耗;可以集成多種芯片和器件,如門極驅動電路、去耦電容、散熱器等,進一步提高功率集成密度,縮小封裝體積。但是,三維封裝目前也面臨一些挑戰,如芯片疊層互連帶來的熱管理、生產工藝和良率等問題,制程工藝有待進一步完善[6,19]。
二次注塑封裝結構是在傳統引線鍵合的封裝結構基礎上,將芯片直接粘接在引線框架上,去除了鍵合引線,并用環氧樹脂進行注塑封裝的結構。與引線鍵合的封裝結構相比,注塑封裝的芯片頂部連接面積增大,使得散熱效率提高;寄生電感降低,使得功率損耗降低,并且非常利于模塊化批量生產,在電動汽車的整流器中得到廣泛應用。
雙面連接結構是將芯片分別與上、下基板連接,例如西門康公司提出的SKiN功率模塊[20]、富士電機提出的銅針互連SiC功率模塊[21]等,可以達到去除鍵合引線的目的。雙面連接封裝結構主要有兩個優點:(1)消除發射極表面的引線鍵合,有效降低寄生電感,減小電壓過沖和功率損耗,提高開關性能;(2)實現芯片上下兩個方向散熱,提高散熱效率,有效降低芯片結溫,從而減緩失效。美國橡樹嶺國家實驗室提出了一種雙面連接DBC基板封裝的Si IGBT或SiC MOSFET功率模塊,相比于傳統的引線鍵合模塊,其電感降低62%,開關損耗降低50%~90%,散熱效率提高40%~50%[22]。
但雙面連接結構也有一些缺點。[敏感詞],相比于引線鍵合模塊,雙面連接結構具有更多層材料,加大了封裝工藝的復雜性。第二,各層材料的CTE不同,熱失配會產生更大的熱-機械應力,降低了連接層可靠性。為了降低熱-機械應力,一些與芯片CTE匹配的金屬,如Mo或Cu/Mo/Cu[23]等被用作中介層材料。第三,在實現不同厚度的多芯片雙面連接的功率模塊時,如圖5所示,需要可以在芯片和DBC基板之間電鍍或連接不同高度的微型金屬柱(Micro-Metal Post)或銅頂針(Cu Pin)等,解決多芯片厚度不同帶來的高度差異問題[6]。第四,錫基釬料是模塊封裝中最常用的互連材料,在雙面連接模塊封裝過程中,通常需要多個連接步驟,這就需要一組具有不同熔點的釬料,限制了模塊的服役溫度。因此在雙面連接封裝結構中,具有高導熱、高導電和高熔點的燒結銀焊膏成為了互連材料的優先選擇。
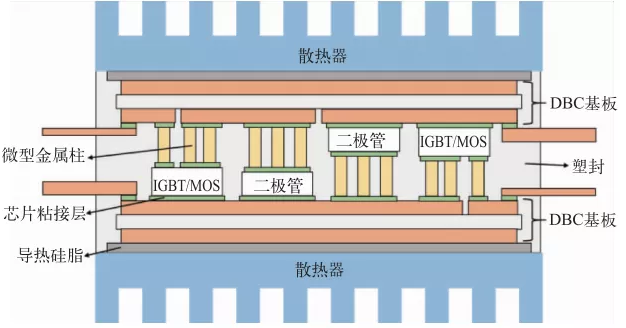
圖5 雙面連接封裝結構[6]
器件集成封裝是在模塊里集成多種功能的器件,例如集成門極驅動電路、去耦電容、溫度傳感器、電流傳感器和保護電路等[18]。器件集成封裝具有很多優點,例如通過集成門極驅動電路和去耦電容,可以降低母排或模塊外部接插件的寄生電感,縮短功率器件和門極驅動之間的連接,降低門極回路電感,實現抑制電磁干擾,提高均流性能和開關速度。但是該封裝結構也存在一定的局限性,例如,集成的門極驅動電路一般比較簡單,模塊的整體尺寸、載流能力和開關頻率受各集成器件的限制。此外,在器件集成封裝之前,需要檢驗各器件的耐溫性能,避免因為器件集成距離太近,影響溫度敏感器件的正常工作[5]。
三維集成封裝結構形式如圖6所示,三維封裝結構主要分為疊層型三維封裝和埋置型三維封裝[24],是在二維封裝的基礎上,采用引線鍵合、倒裝芯片、微凸點、球珊陣列(Ball Grid Array,BGA)、硅通孔(Through Silicon Via,TSV)、PCB埋置等工藝技術,在垂直方向上實現多芯片的疊層互連[25-27]。
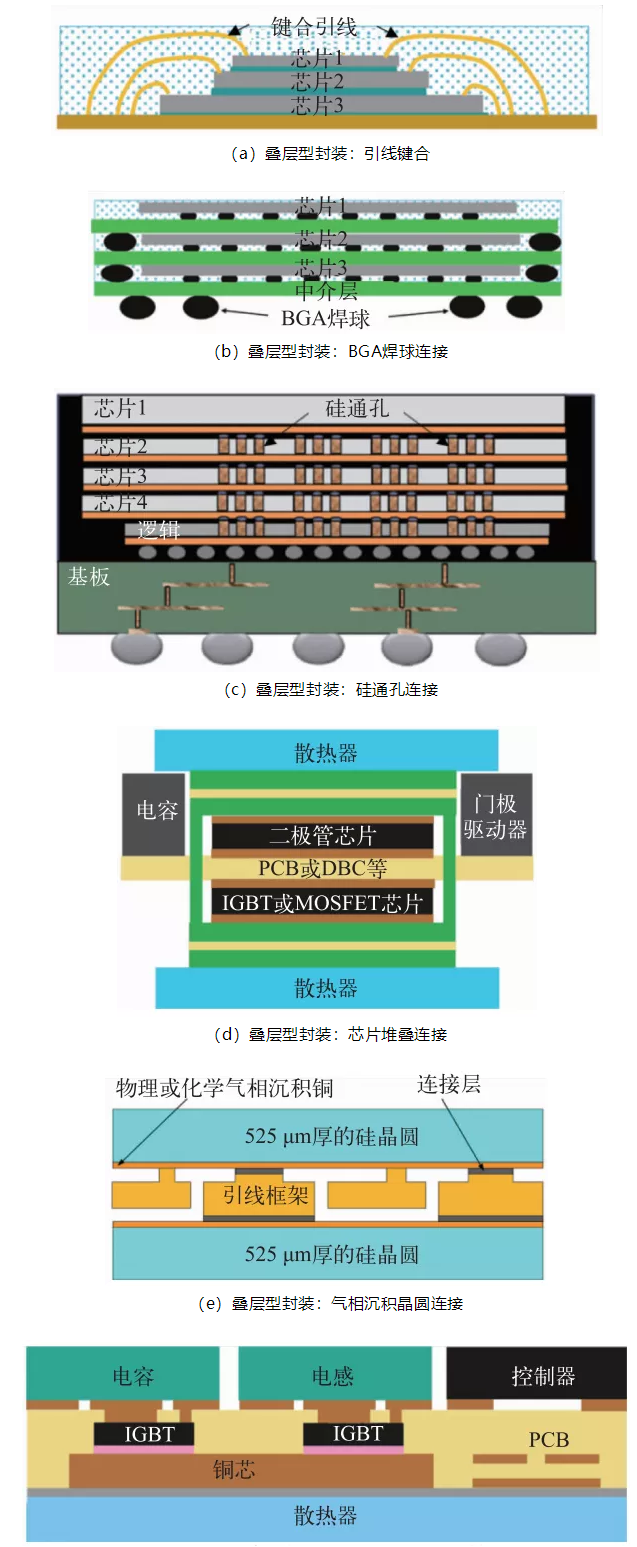
圖6 三維集成封裝結構形式示意圖[6,29-31]
在疊層型三維封裝中,硅通孔是最受關注的技術之一,是利用穿透襯底的硅通孔的垂直互連,實現不同芯片之間的電氣互連[28]。硅通孔封裝關鍵技術包括硅通孔成形、填充、芯片減薄和互連等。具體步驟為:首先通過激光打孔、干法刻蝕或濕法刻蝕形成通孔,然后采用化學氣相沉積等方法填充SiO2絕緣層和銅導電層,其次通過磨削加工減薄芯片,最后通過金屬間鍵合或粘接等方法實現芯片互連[29]。與傳統平面二維引線互連結構相比,硅通孔三維結構具有尺寸小、重量輕、硅片使用效率高、縮短信號延遲同時降低功耗等優點,被廣泛應用于三維晶圓級、系統級和集成電路封裝中。但它也存在一定的局限性,[敏感詞]是可靠性,硅通孔封裝結構的功率密度高,疊層芯片的熱管理問題較大;第二是成本高,封裝結構、工藝和測試復雜。
埋置型三維封裝,是采用銅線和微孔代替鍵合引線,將芯片嵌入在PCB層壓板中,可以縮小體積、提高可靠性,并且易于系統集成[30]。此結構面臨[敏感詞]的挑戰是熱-機械性能較差,受限于傳統PCB材料的低玻璃轉化溫度和高CTE帶來的熱-機械應力,其服役溫度較低[18]。此外,FR4-PCB層壓板的剝離強度較低,約為0.9~1.25 N/mm,相比于DBC基板,PCB板嵌入式封裝的模塊可以承受的額定功率較低[3]。
除了上述焊接式連接之外,還可以通過壓接形成三維封裝,典型案例如圖7所示,為西碼(Westcode)IGBT壓接模塊內部結構圖[32],各組件由外部施加的機械壓力取代引線、釬焊或燒結形成物理連接,結構簡單、成本較低、可靠性高,在高壓大電流電網中得到了廣泛應用。但是在壓接模塊中,對模塊的內部尺寸、各組件的平整度和表面質量要求高,接頭的導熱和導電性能受壓力大小和均勻性的影響很大,需要選擇合適的合模壓力來保證較小的接觸電阻和接觸熱阻,但會不可避免地受到表面粗糙度和結構變形的影響。在壓接結構中常引入CTE較小的彈性緩沖結構和材料,如Mo或Be墊片、彈簧片等,來均勻壓力、降低熱-機械應力,提高可靠性。
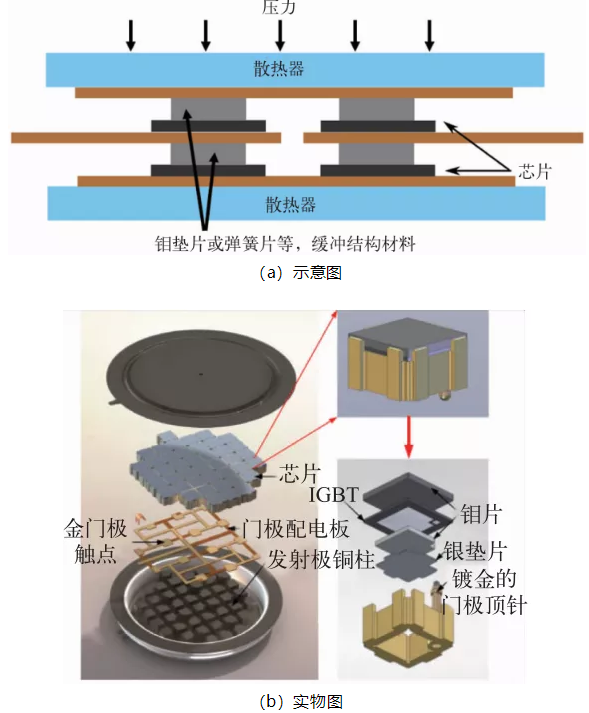
圖7 西瑪的IGBT壓接模塊內部結構[6,32]
4
功率電子封裝的關鍵材料、連接技術和結構設計,逐漸向去除引線、提高散熱性能、提高集成密度等方向發展,來滿足高溫、高壓、高頻環境的可靠應用。隨著第三代半導體器件的推廣應用,燒結銀焊膏連接材料、硅通孔技術、三維集成封裝結構等是未來發展的主要趨勢,相信其應用前景無限廣闊。
免責聲明:本文轉載自“ 電子與封裝”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。
友情鏈接:站點地圖 薩科微官方微博 立創商城-薩科微專賣 金航標官網 金航標英文站
Copyright ?2015-2022 深圳薩科微半導體有限公司 版權所有 粵ICP備20017602號-1