服務熱線
0755-83044319

發布時間:2022-07-27作者來源:薩科微瀏覽:8170
以ASML的光刻機為例,其主要由光源模組(Source)、光罩模組(Reticle)、聚光鏡(Optics)和晶圓模組(Wafer)四大模組組成。
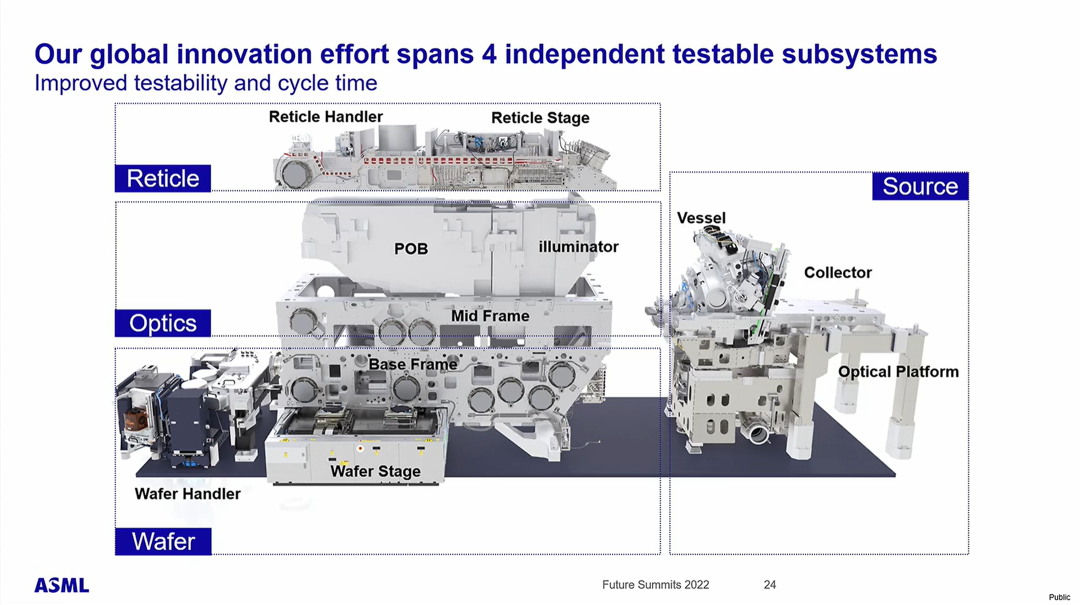
圖1:ASML High NA光刻機
紫外光從光源模組(Source)生成之后,被導入到照明模組(illumination module,該系統要對光的能量、均勻度、形狀進行檢測和控制),光穿過光罩后,聚光鏡模組(Optics)將影像聚焦成像在晶圓表面的光阻層上。
其中,光罩模組可分為光罩傳送模組(Reticle Handler)及光罩平臺模組(Reticle Stage)。光罩傳送模組負責將光罩由光罩盒一路傳送到光罩平臺模組,而光罩平臺模組負責承載及快速來回移動光罩;晶圓模組分為晶圓傳送模組(Wafer Handler)及晶圓平臺模組(Wafer Stage)。晶圓傳送模組負責將晶圓由光阻涂布機一路傳送到晶圓平臺模組,而晶圓平臺模組(一般是雙平臺)負責承載晶圓及精準定位晶圓來曝光。
光刻工藝的基本原理是,利用涂敷在襯底表面的光刻膠的光化學反應作用,記錄掩模版上的電路圖形,從而實現將集成電路圖形從設計轉印到襯底的目的。如下圖所示:首先,使用涂膠機在襯底表面涂敷光刻膠;其次,使用光刻機對涂有光刻膠的襯底進行曝光,利用光化學反應作用的機制,記錄光刻機傳輸的掩模版圖形信息,完成掩模版圖形到襯底的保真傳輸、轉印;然后使用顯影機對曝光襯底進行顯影,再刻蝕;最后去除受到殘留的光刻膠。
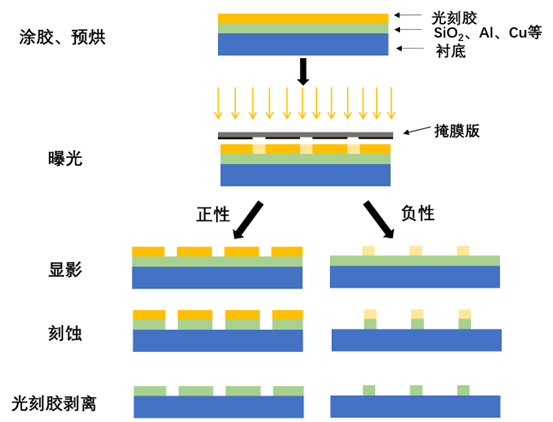
圖2:光刻工藝流程
集成電路經過幾十年的發展,隨著工藝節點不斷縮小至7nm以下,曝光波長逐漸縮短至13.5nm,光刻技術也在逐步完善成熟,從接觸/接近式光刻、光學投影光刻、步進重復光刻、掃描光刻、到浸潤式光刻和[敏感詞]的EUV光刻。
接觸/接近式光刻
接觸式光刻技術出現于20世紀60年代,它是小規模集成電路(SSI)時代的主要光刻手段,主要用于生產特征尺寸大于5μm的集成電路。其工作原理為近場菲涅爾衍射(Fresnel Diffraction)成像,其[敏感詞]分辨率可以達到亞微米級,掩模版上的圖形與曝光在襯底上的圖形在尺寸上基本是1:1的關系,即掩模版與襯底的尺寸一樣大,可以一次曝光整個襯底。在接觸/接近式光刻機中,掩模版與襯底表面的光刻膠直接接觸,減小了光的衍射效應,但在接觸過程中襯底與掩模版之間的摩擦會在二者表面形成劃痕,與此同時很容易產生顆粒沾污。這會降低襯底成品率以及掩模版的使用壽命,故接近式光刻技術得以引入。

圖3:接觸式光刻示意圖
接近式光刻技術于20世紀70年代被廣泛應用,與接觸式光刻相比,接近式光刻中的掩模版與襯底上的光刻膠并未直接接觸,而是留有被氮氣填充的間隙。掩模版浮在氮氣之上,掩模版與襯底之間的間隙大小由氮氣的氣壓來決定。在接近式光刻中,最小分辨尺寸與間隙成正比,間隙越小,最小分辨尺寸越小,也即分辨率越高。一般來說,襯底的平整度在1~2μm,要使掩模版懸空在襯底上方而不碰到襯底,掩模版與襯底的最小間隙需控制在2~3μm,這使得接近式曝光機的空間分辨率極限約為2μm。隨著特征尺寸縮小,出現了投影光刻技術。

圖4:接近式光刻示意圖
投影光刻技術
投影光刻技術自20世紀70年代中后期開始替代接觸/接近式光刻,基于遠場傅里葉光學成像原理,在掩模版和光刻膠之間采用了具有縮小倍率的投影成像物鏡,可以有效提高分辨率。
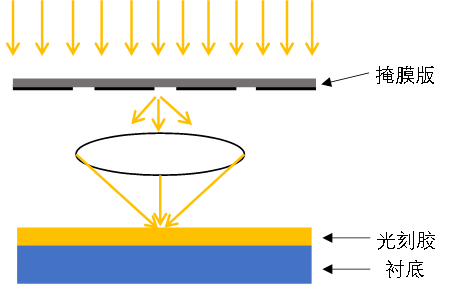
圖5:投影光刻示意圖
投影光刻的基本分辨率計算公式為:

圖6:投影光刻的基本分辨率計算公式
式中,k1為工藝因子,其理論極限值是0.25;NA為成像物鏡的數值孔徑;λ為所使用的光源的波長。可見要想提高分辨率,就要增大數值孔徑NA,縮減波長以及減小工藝因子k1。目前主流的曝光波長從g線(436nm)、i線(365nm)、KrF(248nm)、ArF(193nm),一直縮減到EUV(13.5nm)。EUV光源波長是光刻機能夠使用的[敏感詞]波長,最短可以達到6.8nm。在ASML最[敏感詞]的第二代High-NA光刻機,其孔徑也由0.33增大至0.55。
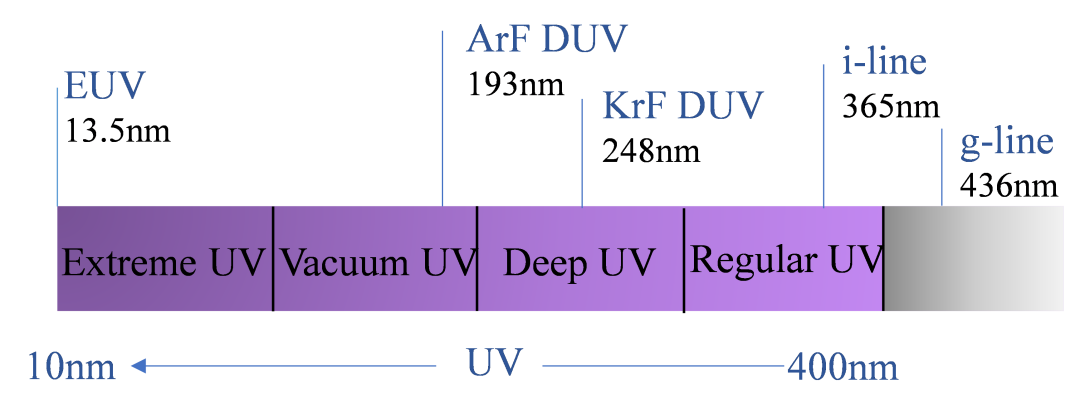
圖7:光刻工藝的光源的變化
早期,投影光刻技術中掩模版與襯底圖形尺寸比例為1:1,然而隨著集成電路特征尺寸的不斷縮小以及襯底尺寸的增大,縮小倍率的步進重復光刻技術問世,替代了圖形比例為1:1的掃描光刻方式。
步進重復光刻技術
步進重復光刻利用22mmx22mm的典型靜態曝光視場(FOV)和縮小比為5:1或4:1的光學投影物鏡,將掩模版上的圖形縮小轉印到襯底上。下圖是步進重復光刻原理圖。在光刻過程中,掩模版固定不動,襯底晶圓步進運動,以完成一片晶圓全部曝光工作。目前步進重復光刻主要應用于0.25μm以上工藝,以及先進封裝領域。當IC工藝來到0.25μm以下時,由于步進掃描光刻機在掃描曝光視場尺寸及曝光均勻性上均具有優勢,使得步進重復光刻機的應用開始縮減。
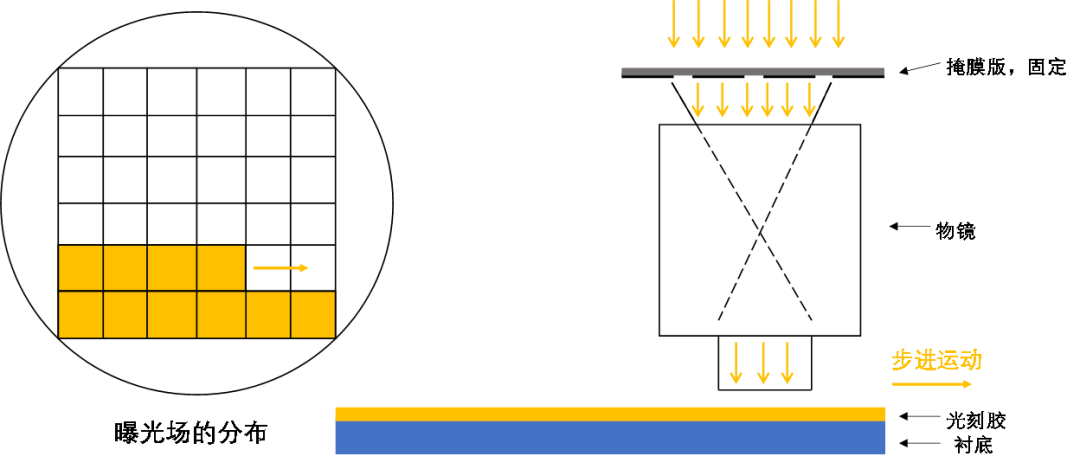
圖8:步進重復光刻示意圖
步進掃描光刻技術
在步進掃描光刻中,單場曝光采用動態掃描方式,即掩模板相對襯底晶圓同步完成掃描運動;完成當前曝光后,晶圓由工作臺承載步進至下一步掃描場位置,繼續進行重復曝光;重復步進并掃描曝光多次,直至整個晶圓所有場曝光完畢。步進掃描光刻的投影物鏡倍率通常為4:1,即掩模板圖形尺寸為晶圓圖形尺寸的四倍,掩模臺掃描速度也為工作臺的4倍(在光刻中要時刻、嚴格保持掩模臺相對工作臺的高速、高精度同步運動。例如在浸潤式光刻機中,工作臺掃描速度達0.8m/s,對應掩模臺速度達到3.2m/s,同時相對運動控制精度達到nm量級),且掃描方向相反,下圖是步進掃描光刻示意圖。
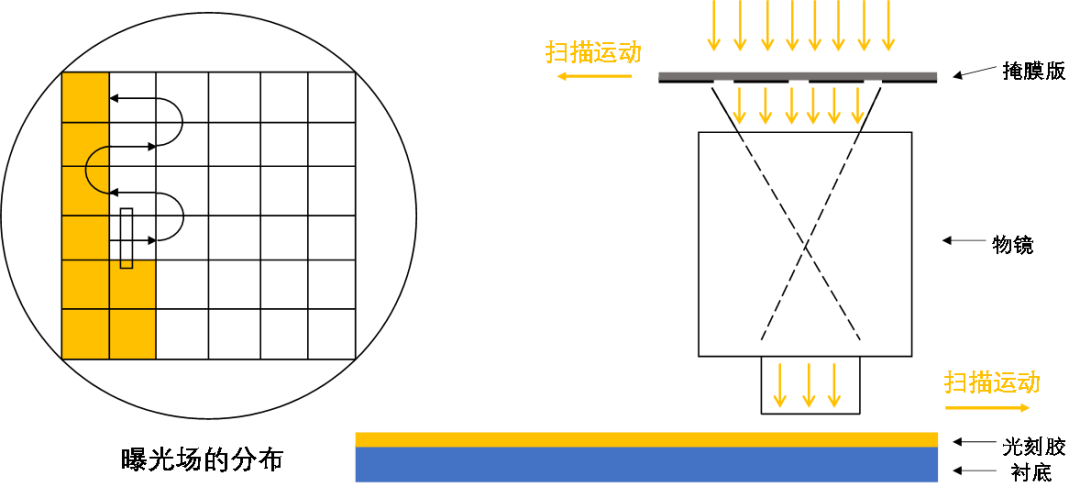
圖9:步進掃描光刻示意圖
通過配置不同種類的光源(如i線、KrF、ArF),步進掃描光刻或者基于步進掃描光刻改進的光刻技術可支撐半導體前道工藝所有的技術節點。對于典型的硅基底CMOS工藝,從0.18μm節點開始便大量采用步進掃描光刻;目前在7nm以下工藝節點使用的極紫外光刻機(EUV)也采用步進掃描方式。
浸潤式光刻技術
根據上面的公式,隨著線寬越來越小,要想得到更小的光刻成像分辨率,可以選擇更短的波長,或者提高數值孔徑(NA),簡單來說,數值孔徑和投影物鏡直徑大小正相關,可以通過增加投影物鏡的直徑來提高數值孔徑。同時,單個透鏡本身的光學特性會導致原始圖像的失真(像差),因此需要靠不同透鏡的組合來修正圖像的形變。在ASML DUV光刻機中的先進機種,投影物鏡的高度超過1米,直徑大于40厘米,物鏡內各種鏡片的數量超過15片。
在干式光刻機中,當光從投影物鏡射出時,由玻璃介質進入空氣介質,會產生折射效應,射出投影物鏡的光角度會產生變化,最終在晶圓表面聚焦成像。當我們縮小線寬,為了仍可收到1階衍射光而加大投影物鏡的直徑時,從投影物鏡內聚焦的光角度也會愈來愈大,再經過折射效應,射出投影物鏡的光角度會愈來愈接近水平。最后,由于角度太大加上折射效應,投影物鏡內的光產生全反射而返回物鏡內,無法成像。如下圖所示。
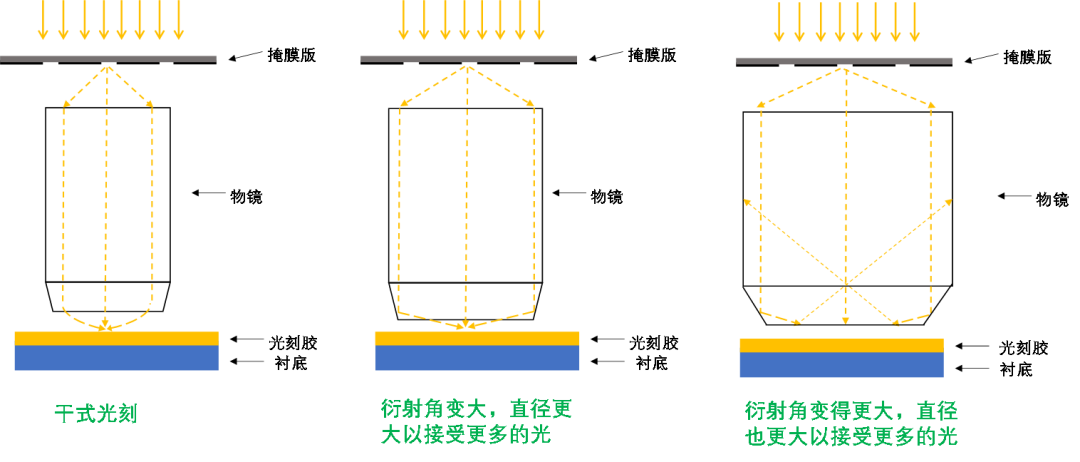
圖10:干式光刻示意圖
采用ArF的光源的掃描光刻機的極限就在于65nm的線寬,小于65nm的線寬,光射無法從物鏡中出來,即使再增大物鏡直徑也是徒勞。
浸潤式光刻技術就出現了,其在投影物鏡的下方和晶圓之間充滿了水。由于水的折射率和玻璃接近(在193nm波長的雷射中,折射率空氣=1,水=1.44,玻璃約為1.5),從投影物鏡射出的光進入水介質后,折射角較小,由此折射光就可以正常從物鏡中折射出來。

圖11:光線在玻璃、空氣、水中的折射
目前主流采用的純凈水的折射率為1.44,所以ArF光源加浸潤技術實際等效的波長為193nm/1.44=134nm。采用ArF的光源浸潤式光刻的最小分辨率可以達到38nm。為了實現更小工藝線寬的要求,通過采用多重圖形技術(多重曝光),可使光刻水平進一步提高,可支撐7nm節點工藝。
值得一提的是,在未出現浸潤式光刻技術之前,業界半導體研發團隊都在專注于157nm波長技術的研發,來自我國臺灣地區林本堅教授,創造性地提出“浸潤式微影技術”后,ASML開始與臺積電合作開發浸潤式光刻機,并在 2007年成功推出[敏感詞]臺浸潤式光刻機TWINSCANXT:1900i,并一舉壟斷市場。當時的另兩大光刻巨頭尼康、佳能主推的157nm 光源干式光刻機被市場拋棄,這也是尼康、佳能由盛轉衰,ASML一家獨大的重要轉折點。
浸潤式光刻技術加上多重曝光技術雖然能最小支撐7nm工藝,但在集成電路實際大規模生產中,其工藝復雜、同時成本又很高,伴隨著工藝節點來到5nm,在業界又引入了EUV光刻技術。
EUV光刻技術
相對于浸潤式光刻,引入波長10-14nm的極紫外光作為曝光光源,形成的EUV光刻工藝,不光可以減小掩模版數目,節約成本,同時可以提高光刻的精度與可靠性。引入極紫外光,設備對光源功率以及光學系統地要求極高。據了解,ASML 從1999年開始EUV光刻機的研發工作,原計劃在2004年推出產品。但直到2010年ASML才研發出[敏感詞]臺EUV原型機, 2016年才實現下游客戶的供貨,比預計時間晚了十幾年。

圖12:ASML下一代High NA的工藝路線
ASML[敏感詞]代EUV NXE3400B型號的光刻機,其數值孔徑為0.33、光源波長為13.5nm、掃描視場為26mm×33mm、光學分辨率可以達到13nm半周期。據了解,臺積電已使用該設備實現了5nm邏輯芯片的量產。未來,對于更先進的節點,ASML計劃2024量產高數值孔徑(NA=0.55)極紫外光刻技術,其分辨率為8nm半周期,可以更快更好地曝光更復雜的集成電路圖案,同時密度增加2.9倍,全面支持3nm以下乃至埃米級工藝節點。臺積電于今年6月份的技術論壇上曾表示,新一代High NA光刻設備將于2024年用于生產納米片晶體管(GAAFET)架構的2nm(N2)芯片,預計在2025年量產。
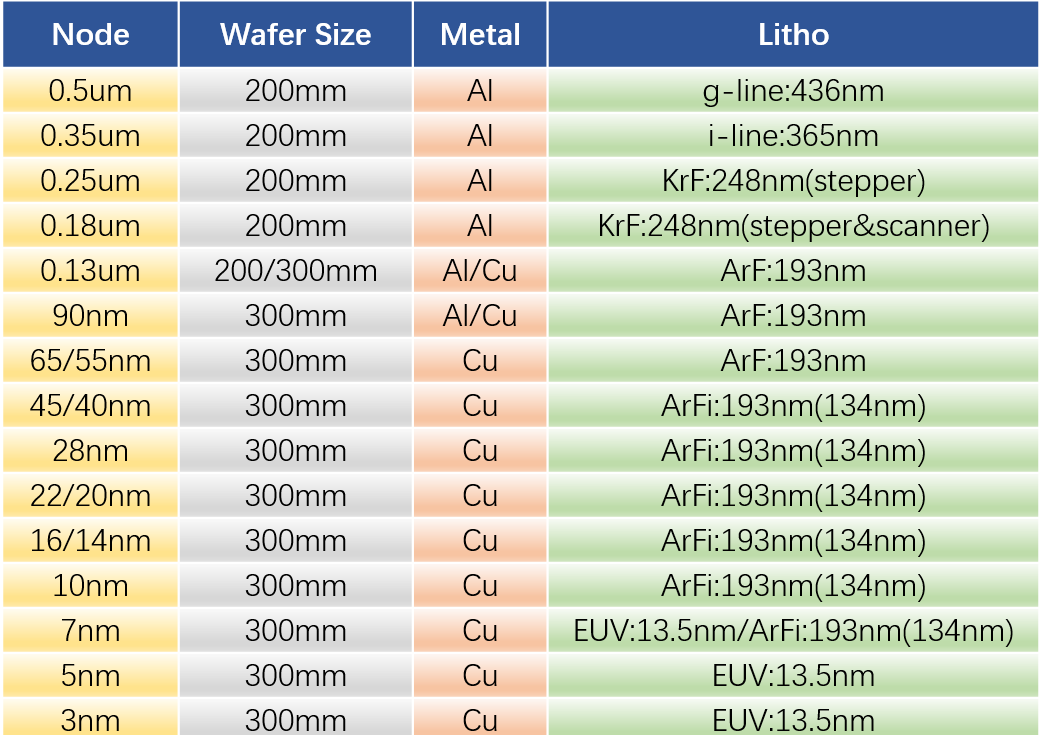
圖13:各個工藝節點和光刻技術的關系圖
無掩模光刻技術
無掩模光刻也稱直寫光刻,是指計算機控制的高精度光束聚焦投影至涂覆有感光材料的襯底上,無需掩膜直接進行掃描曝光。主要有電子束直寫光刻、離子束直寫光刻、激光直寫光刻等,其特點是靈活性高,可柔性制作集成電路,但生產效率很低,在集成電路大規模生產中運用較少,一般用于集成電路器件原型的研制驗證制作、光刻掩模版的制作等。
光刻技術的演變勢必也要帶來相關材料的更替,其中就包括了半導體材料皇冠上的明珠——光刻膠。作為集成電路電子化學品中技術壁壘[敏感詞]的材料,其純度要求高、生產工藝復雜,同時還需要較長的技術積累。下期我們將對光刻膠材料相關技術與市場現狀進行梳理,敬請關注。
*免責聲明:本文由作者原創,文章內容系作者個人觀點。如有異議請聯系薩科微,我們將在[敏感詞]時間進行處理。
友情鏈接:站點地圖 薩科微官方微博 立創商城-薩科微專賣 金航標官網 金航標英文站
Copyright ?2015-2022 深圳薩科微半導體有限公司 版權所有 粵ICP備20017602號-1