服務熱線
0755-83044319

發布時間:2024-09-30作者來源:薩科微瀏覽:1200
晶圓清洗(Wet Clean)是半導體制造工藝中至關重要的步驟之一,其目的是去除晶圓表面的各種污染物,確保后續工藝步驟能夠在潔凈的表面上進行。

圖:批量的晶圓清洗
隨著半導體器件尺寸的不斷縮小和精度要求的不斷提高,晶圓清洗工藝的技術要求也日益嚴苛。晶圓表面任何微小的顆粒、有機物、金屬離子或氧化物殘留都可能對器件性能產生重大影響,進而影響半導體器件的成品率和可靠性。
一、晶圓清洗的核心原理
晶圓清洗的核心在于通過物理、化學以及其他方法有效去除晶圓表面的各類污染物,以確保晶圓具有適合后續加工的潔凈表面。
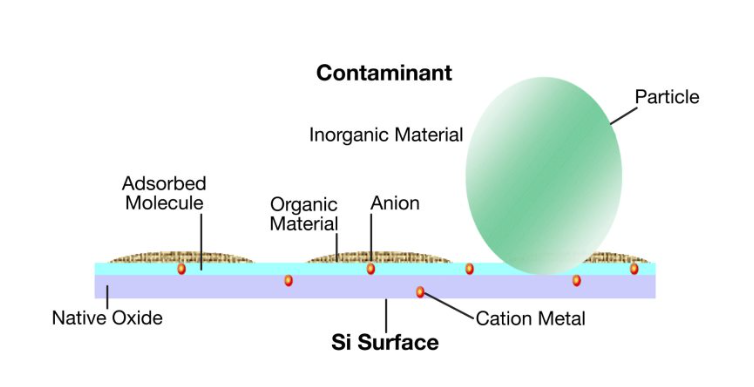
圖:硅片表面的污染物
表:晶圓表面不同污染物及其影響
Type of Contamination
Main Influences on Device Characteristics
|
Particle Contamination |
|
|
|
Metallic Contamination |
Alkali Metals |
|
|
Heavy Metals |
|
|
|
Chemical Contamination |
Organic Material |
|
|
Inorganic Dopants (B, P) |
|
|
|
Inorganic Bases (amines, ammonia) & Acids (SOx) |
|
|
|
Native and Chemical Oxide Films Due to Moisture, Air |
|
|
具體來說,晶圓清洗工藝的目標包括:
顆粒物的去除:利用物理或化學手段,去除附著在晶圓表面的微小顆粒物。較小的顆粒物由于與晶圓表面之間存在較強的靜電吸附力,去除的難度較大,需要特別處理。
有機物的去除:晶圓表面可能附著油脂、光刻膠殘留等有機污染物,這些污染物通常通過強氧化劑或溶劑來去除。
金屬離子的去除:金屬離子殘留在晶圓表面可能導致電性能的下降,甚至影響晶圓后續的制程,因此需要使用特定的化學溶液進行處理。
氧化物的去除:部分工藝要求晶圓表面沒有氧化物層,如氧化硅等,因此在某些清洗步驟中需要去除自然氧化層。
晶圓清洗技術的難點在于既要高效去除污染物,又不能對晶圓表面產生不良影響,例如不能引起表面粗糙化、腐蝕或其他物理損傷。
二、晶圓清洗工藝流程
晶圓清洗工藝通常分為多個步驟,以確保污染物的全面去除和表面的完全潔凈。
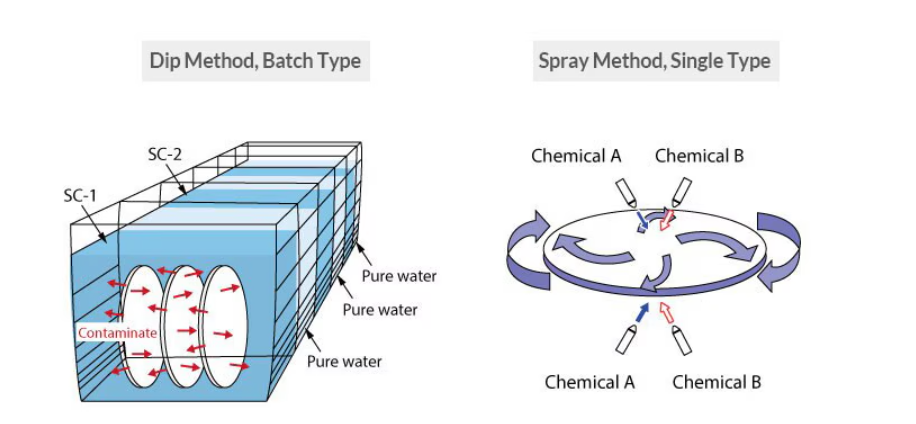
圖:Batch類型和單片清洗對比
典型的晶圓清洗工藝包括以下幾個主要步驟:
1. 預清洗(Pre-Clean)
預清洗的目的是去除晶圓表面的松散污染物和大顆粒,這通常通過去離子水(DI Water)沖洗和超聲波清洗來完成。去離子水能夠初步去除晶圓表面的顆粒和溶解的雜質,而超聲波清洗則利用空化效應破壞顆粒與晶圓表面的結合力,使顆粒易于脫落。
2. 化學清洗(Chemical Cleaning)
化學清洗是晶圓清洗工藝的核心步驟之一,它利用化學溶液去除晶圓表面的有機物、金屬離子和氧化物。
去除有機物:通常使用丙酮或氨水/過氧化氫混合液(SC-1)來溶解和氧化去除有機污染物。SC-1溶液的典型配比為NH?OH:H?O?:H?O = 1:1:5,使用溫度約為20°C。
去除金屬離子:使用硝酸或鹽酸/過氧化氫混合液(SC-2)去除晶圓表面的金屬離子。SC-2溶液的配比通常為HCl:H?O?:H?O = 1:1:6,溫度保持在80°C左右。
去除氧化物:某些工藝要求去除晶圓表面的自然氧化層,這時會使用氫氟酸(HF)溶液。HF的典型配比為HF:H?O = 1:50,常溫下即可使用。
3. 終清洗(Final Clean)
在化學清洗后,晶圓通常需要進行終清洗,以確保表面沒有殘留的化學物質。終清洗主要使用去離子水進行徹底的沖洗。此外,臭氧水清洗(O?/H?O)也被用于進一步去除晶圓表面的殘留污染物。
4. 干燥
清洗后的晶圓必須迅速干燥,以防止水痕或污染物的重新附著。常用的干燥方法包括旋轉甩干和氮氣吹掃,前者通過高速旋轉將晶圓表面的水分甩除,后者通過干燥氮氣的吹拂來確保表面的完全干燥。
表:用于CMOS工藝的清洗解決方案
Contaminant
Cleaning Procedure Name
Chemical Mixture Description
Chemicals
|
Particles |
Piranha (SPM) |
Sulfuric acid/hydrogen peroxide/DI water |
H2SO4/H2O2/H2O 3-4:1; 90°C |
|
SC-1 (APM) |
Ammonium hydroxide/hydrogen peroxide/DI water |
NH4OH/H2O2/H2O 1:4:20; 80°C |
|
|
Metals (not copper) |
SC-2 (HPM) |
Hydrochloric acid/hydrogen peroxide/DI water |
HCl/H2O2/H2O1:1:6; 85°C |
|
Piranha (SPM) |
Sulfuric acid/hydrogen peroxide/DI water |
H2SO4/H2O2/H2O3-4:1; 90°C |
|
|
DHF |
Dilute hydrofluoric acid/DI water (will not remove copper) |
HF/H2O1:50 |
|
|
Organics |
Piranha (SPM) |
Sulfuric acid/hydrogen peroxide/DI water |
H2SO4/H2O2/H2O 3-4:1; 90°C |
|
SC-1 (APM) |
Ammonium hydroxide/hydrogen peroxide/DI water |
NH4OH/H2O2/H2O 1:4:20; 80°C |
|
|
DIO3 |
Ozone in de-ionized water |
O3/H2O Optimized Mixtures |
|
|
Native Oxide |
DHF |
Dilute hydrofluoric acid/DI water |
HF/H2O 1:100 |
|
BHF |
Buffered hydrofluoric acid |
NH4F/HF/H2O |
三、常見的晶圓清洗方法
1. RCA 清洗法
RCA清洗法是半導體行業中最為經典的晶圓清洗方法之一,由RCA公司開發,已有超過40年的歷史。該方法主要用于去除有機物和金屬離子污染物,并且可以分為SC-1(標準清洗1)和SC-2(標準清洗2)兩步完成。
SC-1清洗:主要去除有機污染物和顆粒,溶液為氨水、過氧化氫和水的混合液,形成一層薄氧化硅層。
SC-2清洗:主要去除金屬離子污染物,使用鹽酸、過氧化氫和水的混合溶液,留下薄的鈍化層,防止晶圓表面再次污染。

2. 吡拉尼亞清洗法(Piranha Etch clean)
吡拉尼亞清洗法是一種高效的有機物去除方法,使用硫酸和過氧化氫的混合溶液,典型的配比為3:1或4:1。由于該溶液具有極強的氧化性,可以去除大量的有機物質和頑固的污染物。這種方法需要在嚴格的控制條件下進行,尤其是在溫度和濃度方面,以避免對晶圓的損傷。

3. 超聲波清洗和兆聲波清洗(Megasonic Cleaning)
超聲波清洗利用高頻聲波在液體中產生的空化作用來去除晶圓表面的污染物。相比傳統的超聲波清洗,兆聲波清洗具有更高的頻率,能夠更高效地去除亞微米級別的顆粒,而不會對晶圓表面造成損傷。

4. 臭氧清洗(Ozone Cleaning)
臭氧清洗技術利用臭氧的強氧化性來分解和去除晶圓表面的有機污染物,最終將這些污染物轉化為無害的二氧化碳和水。這種方法不需要使用昂貴的化學試劑,并且對環境污染較小,因此逐漸成為晶圓清洗領域的一種新興技術。

四、晶圓清洗工藝設備
為了確保晶圓清洗工藝的高效和安全性,半導體制造中使用了各種先進的清洗設備。主要包括以下幾類:
1. 濕法清洗設備
濕法清洗設備包括各種浸泡槽、超聲波清洗槽和旋轉甩干設備。這些設備通過機械力和化學試劑的結合,完成晶圓表面的污染物去除。浸泡槽通常配有溫度控制系統,以確保化學溶液的穩定性和有效性。
2. 干法清洗設備
干法清洗設備主要包括等離子清洗機,利用等離子體中的高能粒子與污染物反應來去除晶圓表面的殘留物。等離子清洗特別適用于需要保持表面完整性而不引入化學物質殘留的工藝。
3. 自動化清洗系統
隨著半導體生產規模的不斷擴大,自動化清洗系統已成為大批量晶圓清洗的[敏感詞]。這類系統通常包括自動傳輸裝置、多槽清洗系統和精密控制系統,以確保每片晶圓都能達到一致的清洗效果。
五、未來趨勢
隨著半導體器件的不斷微縮化,晶圓清洗技術正朝著更高效、更環保的方向發展。未來的清洗技術將更加注重:
亞納米級別顆粒物的去除:現有的清洗技術已經可以處理納米級顆粒,但隨著器件尺寸的進一步縮小,亞納米級顆粒的去除將成為新的挑戰。
綠色環保清洗:減少對環境有害的化學品的使用,開發更環保的清洗方法,例如臭氧清洗和兆聲波清洗等。
更高的自動化和智能化:通過智能化系統,實時監控和調整清洗過程中的各種參數,以進一步提高清洗效果和生產效率。
晶圓清洗技術作為半導體制造中的關鍵環節,其重要性不言而喻。通過多種清洗方法的組合使用,能夠有效去除晶圓表面的各種污染物,為后續工藝提供潔凈的基底表面。隨著技術的不斷進步,清洗工藝也在不斷優化,以適應更高精度、更低缺陷率的半導體制造需求。
免責聲明:本文采摘自“老虎說芯”,本文僅代表作者個人觀點,不代表薩科微及行業觀點,只為轉載與分享,支持保護知識產權,轉載請注明原出處及作者,如有侵權請聯系我們刪除。
友情鏈接:站點地圖 薩科微官方微博 立創商城-薩科微專賣 金航標官網 金航標英文站
Copyright ?2015-2022 深圳薩科微半導體有限公司 版權所有 粵ICP備20017602號-1